IC后道封装的塑封过程浅析
在IC后道封装的塑封过程中,环氧模塑料在熔融状态下充填成型时,包人或卷进去的空气以及饼料中原有的探发性物质在压实阶段时不能完全排出,残留在塑封体内部就形成内部气泡。
其对可靠性的影响有: ①导致塑封体裂纹的产生。 ②使树脂的耐温性能下降。 ③影响电性能。 通过树脂预热时温差工艺,即树脂放人料筒中时,温度高的树脂放在上面,温度低的树脂放在下面,则预热时上面温度高的树脂先熔化充填料筒与树脂饼料之间的间隙,空气就从流道的方向排出,而不会进入树脂的内部。
而在塑封IC设计时,为提高可靠性,将零件最大允许应力限制到低于其最大额定应力值的某一规定值。并在产品中要考虑热量的产生和扩散,避免出现由温度造成的可靠性问题。 5.2 工艺及材料控制 在塑封IC整个生产过程,应加大工艺控制,其主要措施有:减少封装体内水汽含量,避免分层效应 封装体内的实际水汽含量是由密封材料、封装体本身、密封环境释放的水和通过密封处漏人的水汽组成的。为防止水汽侵入,良好的钝化覆盖层(使用磷玻璃或氮化硅)是必要的,减少包封料中的离子沾污物,在包封料中掺人杂质离子俘获剂或离子清除剂,提高塑封料与引线框架间的粘接强度,在塑封料中加入填充物延长水汽渗透路径,使用低吸水性包封料等,另外,从工艺上采取以下措施:
①封装时的环境气氛必须很干燥。 ②封装前各部件应在真空和高温下长时间烘烤,以去除水汽。
③保证器件符合Gm548A-96方法1014A中He检漏的气密性要求,来减少封装体内水汽含量。 (2)减少封装体内部气泡,避免塑封体裂纹的产生;
相关搜索: IC塑封排片机



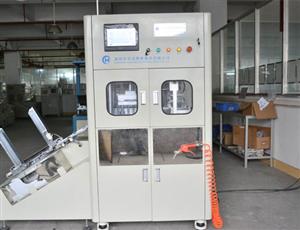




 二维码
二维码

