半导体环氧塑封材料的一些基本常识
国外: 环氧塑封料半导体自动化设备生产厂家主要集中在日本、美国、韩国、新加坡等国,主要有住友电木、日东电工、日立化成、松下电工、信越化学、东芝,Hysol、Plaskon、Samsung等,现在,环氧塑封料的主流产品是适用于0.35μm——0.18μm特征尺寸集成电路的封装材料,研究水平已经达到0.1μm——0.09μm,主要用于SOP、QFP、BGA、CSP、MCM、SIP等
塑封料性能对器件可靠性的影响
2.1 模塑料的吸湿性和化学粘接性
对塑封器件而言,湿气渗入是影响其气密性导致失效的重要原因之一。
湿气渗入器件主要有两条途径:
① 通过塑封料包封层本体;②通过塑封料包封层与金属框架间的间隙。
当湿气通过这两条途径到达芯片表面时,在其表面形成一层导电水膜,并将塑封料中的Na+、CL-离子也随之带入,在电位差的作为下,加速了对芯片表面铝布线的电化学腐蚀,最终导致电路内引线开路。随着电路集成度的不断提高,铝布线越来越细,因此,铝布线腐蚀对器件寿命的影响就越发严重。
针对上述问题,我们必须要求:
模塑料要有较高的纯度,Na+、CL离子降至最低;
模塑料的主要成分环境标环氧树脂与无机填料的结合力要高,以阻止湿气由本体的渗入。
模塑料与框架金属要有较好的粘接性;
芯片表面的钝化层要尽可能地完善,其对湿气也有很好的屏蔽作用。
2.2 模塑料的内应力
由于模塑料、芯片、金属框架的线膨胀系数不匹配而产生的内应力,对器件密封性有着不可忽视的影响。因为模塑料膨胀系数(20-26E-6/℃)比芯片、框架(-16E-6/℃)的较大,在注模成型冷却或在器件使用环境的温差较大时,有可能导致压焊点脱开,焊线断裂甚至包封层与框架粘接处脱离,由此而引起其器件失效。
另外,国内还有部分外资环氧塑封料生产厂家,由于他们依靠国外比较成熟的技术和先进的研发手段,以及强大的实力作为后盾,所以他们的产品主要处在中高档水平,主要应用于QFP、BGA、CSP等比较先进的封装形式以及环保封装领域,基本上占据了国内大部分的中高端市场;由此可见,模塑料的线膨胀系数应尽可能的低,但这个降低是收到限制的,因为在降低应力的同时,模塑料的热导率也随之降低,这对于封装大功率的器件十分不利,要使这两个方面得以兼顾,取决于配方中填料的类型和用量。



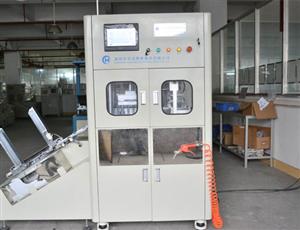




 二维码
二维码

