简析半导体封装模具的发展趋势
半导体塑封模具真正了解他人也不是很多,我们需要了解的就是他的发展趋势,在这个时代大部分人看的都是他的发展怎么样适不适合做,那么我们就来先了解;目前中国模具产品主要还是以中低档为主,技术含量较低,高中档模具多数要依靠进口,其中一个原因就是因相关行业缺失核心技术。如在IC封装模具领域,由于国内IC业整体水平以及国外技术封锁的原由,使得IC封装模具业难以高起点发展。因而,在IT业、汽车业带动模具产品需求增长的同时,提升中国在IT业、汽车业的整体实力是双赢所不可或缺的。
塑封模工艺是半导体器件后工序生产中极其重要的工艺手段之一,一般应用单缸封装技术,其封装对象包括DIP、SOP、QFP、SOT、SOD、TR类分立器件以及片式钽电容、电感、桥式电路等系列产品。如今封装技术正不断发展。芯片尺寸缩小,芯片面积与封装面积之比越来越接近于1,I/O数增多、引脚间距减小。封装技术的发展离不开先进的电子工模具装备,多注射头封装模具(MGP)、自动冲切成型系统、自动封装系统等高科技新产品适应了这一需求。多注射头封装模具(MGP)是单缸模具技术的延伸,是如今封装模具主流产品。其采用多料筒、多注射头封装形式,优势在于可均衡流道,实现近距离填充,树脂运用率高,封装工艺稳定,制品封装质量好。它适用于SSOP、TSSOP、LQFP等多排、小节距、高密度集成电路以及SOT、SOD等微型半导体器件产品封装。



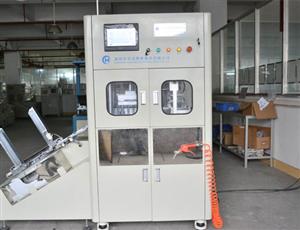




 二维码
二维码

