未来国内外半导体设备技术趋势
很多国家为了满足300mm品圆生产线采用单晶圆片、连续流生产方式,必须使设备、工具、晶圆片都发生变动,它们互相之间应尽量紧凑。目前正在研发“迷你型”生产线,如DIIN计划(2001-2007),投资125亿日元,建立迷你型工厂,以超短出货时间生产数码家电用SoC。而未来驱动各半导体厂投资的新技术为20奈米FinFED和3D NAND制程,需要的半导体机台设备成长,带动相关业者资本支出再攀高。
未来半导体设备技术呈现以下5个发展方向:
1、加工晶圆大尺寸化
不断扩大的晶圆尺寸可以提高产量和降低成本,从而获取更大的利润。2003年世界顶级半导体制造商英特尔、三星、Infineon、Micron、Elpida和力晶半导体等均开工了多条300mm晶圆生产线。
2、高精度化
不断缩小的芯片特征尺寸要求设备高精度化。如其中的关键设备stepper(准分子激光扫描分步投影光刻机)必须通过缩小曝光光束的波长、增大数值孔径(NA)和扩大视场面积、提高分辨率来不断提高光刻精度。
3、设备组合化
随着IC集成度的不断提高,IC制造工艺越来越复杂,工艺流程越来越长,为了减少对晶圆的污染和提高生产效率,设备制造商将多种设备组合在一起,变成联动机,具有多种功能。原来后道封装、测试设备较多制成联动机,现在逐渐扩大到前道设备。
4、加工晶圆单片化
200mm晶圆生产线采用常规的高半成品(WIP)晶圆批处理生产方式。300mm晶圆生产线将采用低半成品、单晶圆片、连续流生产方式,据估计,一家采用单晶圆片流程加工300mm晶圆的工厂每月初始生产的晶圆片数量是加工200mm晶圆片普通工厂的2倍,而且成本和复杂性都大幅度降低。因此,随着晶圆的大尺寸化,对300mm晶圆必须采用单晶圆片连续流生产方式。



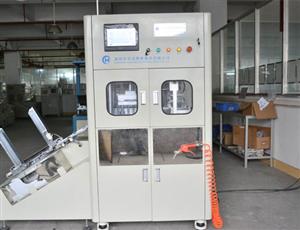




 二维码
二维码

